세팅부터 3D 나노 스캔까지, 약 3분 이내
복잡한 레이저 정렬 없이 시작하는 차세대 AFM 솔루션
처음 도입하는 연구실을 위해 최적화된 AFM
Time to data < 3 min (약 3분 이내)
3클릭 측정 워크플로우
초경량 벤치탑 AFM (약 500g)
원자힘현미경(AFM)은
나노 스케일 표면 분석에 필수적인 장비로 알려져 있지만,
처음 도입을 고려하는 교수님과 연구책임자에게는
여전히 “운영이 어려운 고급 장비”로 인식되는 경우가 많습니다.
그래서 많은 연구실이
AFM이 필요한 상황에서도
외부 분석 의뢰에 의존하거나 도입을 미루고 있습니다.

nGauge AFM은
기존 대형 AFM의 모든 확장 기능을 대체하려는 장비가 아닙니다.
대신,
‘첫 번째 AFM’의 역할에 집중한 장비입니다.

AFM이 필요하다는 것은 알고 있지만, 처음 도입하기에는 부담스럽게 느껴지는 경우가 많습니다. 아래 질문 4가지는 교수·연구책임자가 도입 여부를 판단할 때 가장 자주 확인하는 핵심 포인트를 정리한 것입니다.
다음과 같은 상황이 반복된다면, AFM은 “있으면 좋은 장비”가 아니라 “필요한 장비”에 가깝습니다.
첫 AFM 도입에서 가장 큰 장벽은 “운영 부담”입니다. 아래 조건을 체크해보세요.
장비가 “교수님만 쓰는 장비”가 되면 활용률이 떨어지고, 도입 효과도 작아집니다.
AFM을 내부에서 운용하게 되면 “측정 결과”뿐 아니라 “연구 운영 방식”이 달라지는 경우가 많습니다.
→ 일반적인 조건 기준 Time to data < 3 min
※ 시료 특성 및 스캔 설정에 따라 측정 시간은 달라질 수 있습니다.


nGauge는
AFM의 핵심 구성 요소를
1mm × 1mm 단일 칩에 통합한 AFM-on-a-chip 구조를 적용했습니다.
이를 통해
라는 첫 AFM 도입에 필요한 조건을 충족합니다.
Redux와 nGauge는 모두 ICSPI의 AFM-on-a-chip 기술을 사용하여 나노스케일 이미징을 매우 쉽고 효율적으로 수행할 수 있도록 설계되었습니다.
Redux는 자동화 수준이 더 높은 모델로, 광학 현미경이 통합되어 있으며 모터 구동 XY 스테이지를 제공합니다. 또한 더 큰 샘플을 올릴 수 있는 샘플 플랫폼을 갖추고 있습니다.
👉 사양 비교 보기
아닙니다. AFM-on-a-chip 기술을 사용하기 때문에, 기존 AFM에서 필수였던 번거로운 레이저 정렬 과정이 필요 없습니다.
네, 가능합니다. ICSPI의 AFM-on-a-chip 기술은 모든 제품 간 호환되어 동일한 AFM 칩을 사용할 수 있습니다.
대부분의 샘플은 별도의 복잡한 전처리 없이 바로 스캔이 가능합니다. 투명하거나 불투명한 샘플, 전도성·비전도성 샘플, 접착성이 있거나 없는 샘플 모두 측정할 수 있습니다.
곡면 샘플 또한 문제없이 측정 가능하며, 일반적으로 마이크론 단위 스캔 범위에서는 곡률이 이미지에 큰 영향을 주지 않습니다.
단, 스캔 중 샘플이 움직이지 않는 것이 중요합니다. 포일, 종이와 같은 가벼운 샘플이나 와이어, 머리카락처럼 굴러갈 수 있는 샘플은 유리 슬라이드나 마이카 디스크 등에 고정하는 것을 권장합니다.
네, 가능합니다. 위 질문의 설명을 참고해 주세요.
일반적으로 가능합니다. 전체 샘플의 형상이 크더라도, 실제 측정되는 국부적인 스캔 영역 내에서는 Z 범위를 초과하지 않는 경우가 대부분입니다.
nGauge의 샘플 스테이지는 Z 방향은 모터로 제어되며, XY 방향은 수동 조절 노브를 통해 조정합니다.
일반적으로는 필요하지 않습니다. 다만 요구되는 해상도 수준이나 설치 환경에 따라 필요 여부가 달라질 수 있습니다.
위 질문과 동일한 기준이 적용됩니다.
현재 nGauge는 액체 샘플 스캔을 지원하지 않습니다.
네, 가능합니다. 자세한 내용은 Roughness 기능 안내 페이지를 참고해 주세요.
nGauge는 Intermittent Contact Mode로 동작하며, Topography 이미지와 Phase 이미지를 동시에 수집합니다.
현재 nGauge는 Force-Distance Curve 측정을 지원하지 않습니다.
네, 가능합니다. 장비 크기는 제품 사양 페이지를 참고해 주세요.
nGauge는 현재 진공 환경 사용을 지원하지 않으며, 대기 환경(Ambient Condition)에서의 사용을 전제로 설계되었습니다.


원 클릭, 자동 주파수 Sweep은 5초 안에 완료됩니다.

원 클릭, 10초 내에 자동으로 팁과 샘플의 접근이 완료됩니다.

원클릭, 단 1분 만에 일상적인 스캔을 캡처합니다.







nGauge는 매우 높은 해상도로 3차원 지형 이미지를 수집할 수 있는 다목적 도구입니다.
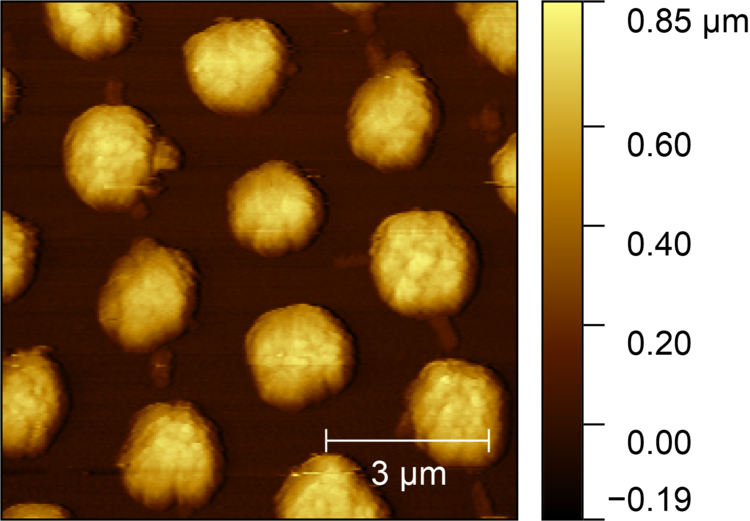

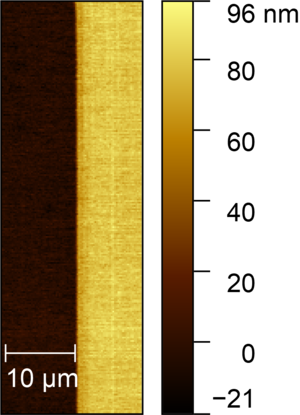
라인 프로파일은 사용자가 선택한 라인을 따라 표면의 높이 정보를 제공합니다.
왼편 기판의 코팅 계면에서 20 µm 라인 스캔입니다.
왼편 어두운 영역은 코팅이 되지 않은 노출된 기판이고 오른편 밝은 색 영역은 코팅입니다.
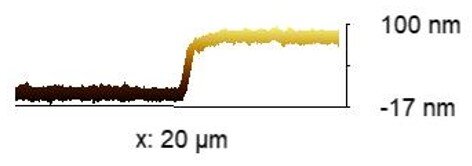

중앙에는 이 지형 이미지의 3차원 보기가 있습니다. 그리고 오른쪽은 코팅을 가로지르는 라인 프로파일의 그래프입니다.
두께 프로파일과 Gwyddion의 통계 도구를 사용하여 이 코팅의 두께가 약 82nm임을 확인할 수 있습니다.
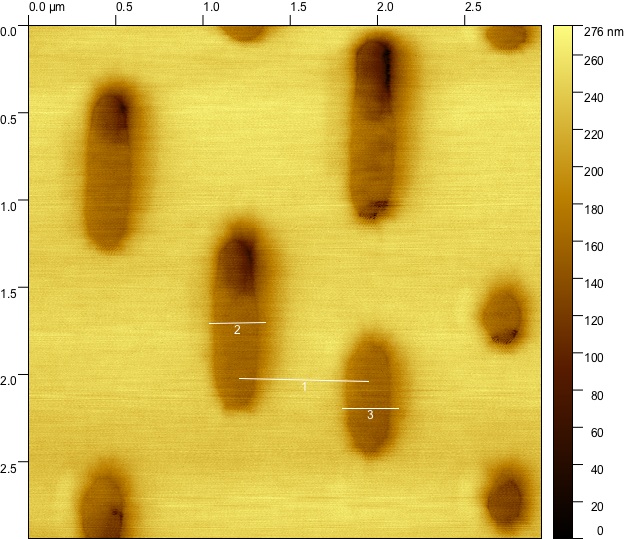

또 다른 유용한 측정은 AFM 이미지의 형상 간 거리입니다.
측면 거리는 Gwyddion을 사용하여 간단하게 측정할 수 있습니다.
아래 왼쪽 이미지에서 DVD의 ” pits”에 대한 3 x 3 micron 스캔에서 우리는 pits (the pitch) 사이의 거리와 피트 자체의 너비를 측정할 수 있습니다.
Gwyddion의 거리 도구를 사용하여 측정하려는 거리를 따라 라인을 추적합니다.
Pit 중심(Line 1) 사이의 거리가 741nm임을 알 수 있습니다. 이것은 DVD pits(740nm)의 실제 피치와 잘 일치합니다.
DVD pits 자체의 너비는 320nm이고 라인 2와 3의 경우 322nm입니다.


표면 거칠기는 표면 질감의 구성 요소입니다. 값이 높을수록 표면이 더 거칠어집니다. 표면 거칠기는 표면 마감이라고도 합니다. 산술 평균 편차(Ra)와 평균 제곱근 편차(Rq)는 거칠기를 설명하는 데 사용되는 일반적인 매개변수입니다.
프로파일로미터 또는 광학 프로파일러와 같은 많은 유형의 장치는 라인 스캔의 데이터를 사용하여 표면 거칠기를 계산합니다.
AFM은 지형 데이터를 2차원으로 수집하기 때문에 표면 거칠기는 1차원 데이터가 아닌 전체 2차원 스캔 영역에서 계산할 수 있습니다.
2-d/area 거칠기 매개변수는 산술(Sa) 및 RMS(Sq)입니다.
티타늄-알루미늄 합금의 AFM 이미지는 통계량 도구의 해당 출력과 함께 왼쪽에 표시되며, 여기서 RMS 거칠기가 11.81nm임을 알 수 있습니다.
표면 거칠기 측정의 예를 제공하기 위해 캐나다 Halifax에 있는 Dalhousie University의 Laurent Kreplak 교수와 협력하여 Richard Price 교수의 그룹이 2017년 12월 Journal of Esthetic and Restorative Dentistry에 발표한 연구에서 치과 합성물의 표면 거칠기에 대한 칫솔질의 효과를 결정하기 위해 nGauge AFM을 사용했습니다.
입자 분석은 AFM의 매우 일반적인 응용 프로그램입니다. 라인 프로필을 사용하여 개별 입자를 볼 수 있지만 몇 개 이상의 입자에 대해서는 루틴을 어떻게든 자동화하는 것이 가장 좋습니다. 입자 분할 루틴은 입자가 있는 평평한 표면에서 입자를 분리하여 수행합니다. 세분화 루틴은 입자 계수에도 사용할 수 있습니다. ImageJ와 같은 소프트웨어는 분할에 사용할 수 있습니다.
입자가 실제로 분리되어 있고 기판과 다른지 여부를 결정하기 위해 위상 이미지로 지형 이미지를 보완하는 것이 가능합니다. 위상 이미징은 아래에 자세히 설명되어 있습니다.
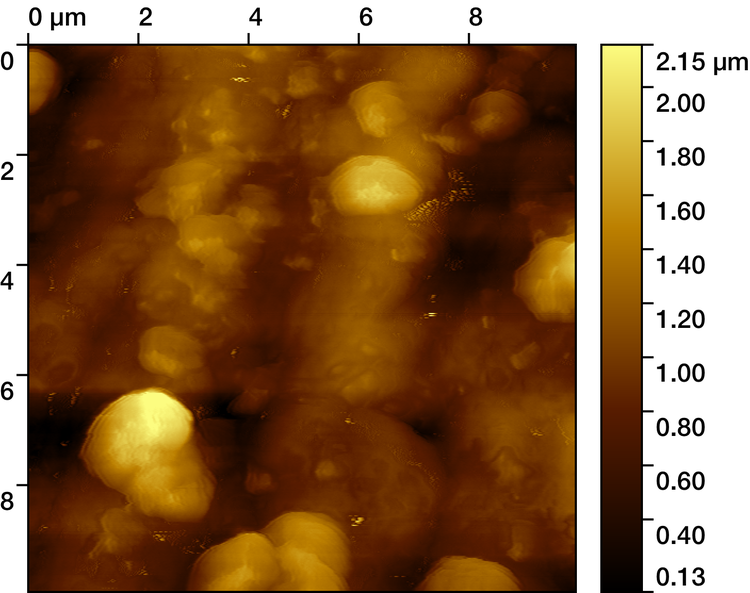
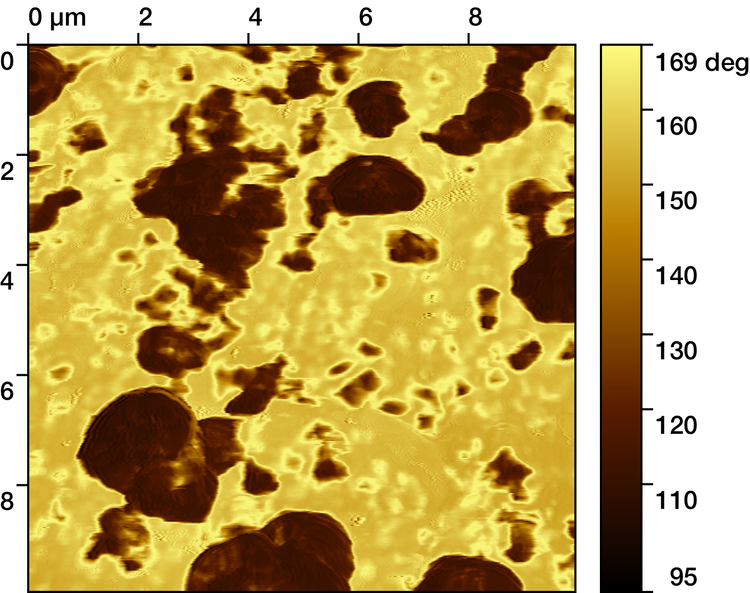
태핑 모드라는 모드에서 작동할 때 AFM은 지형 이미지와 위상 이미지라는 두 가지 다른 이미지를 생성합니다. 위상 이미지는 신호의 위상 변이에서 비롯됩니다. 위상 변이는 구동 신호와 피드백 신호 사이의 지연입니다. 이 지연은 프로브 팁과 표면 사이의 상호 작용으로 인해 발생하며, 이는 접착력, 마찰력 및 점탄성력의 영향을 받을 수 있습니다. (자세한 내용은 Phase Images 블로그 게시물을 참조하십시오.)
위상 이미지의 대비를 사용하여 재료 특성이 다른 영역을 구별할 수 있습니다. 지형 이미지와 위상 이미지가 동시에 생성되기 때문에 두 이미지를 나란히 분석하면 지형 이미지만으로는 숨겨진 정보를 찾을 수 있습니다.
아래는 실리카-폴리머 복합체의 지형(왼쪽) 및 위상(오른쪽) 이미지의 예입니다. 왼쪽에서 표면에서 튀어나온 몇 개의 입자를 볼 수 있습니다. 그것들은 가장 높은 피처이기 때문에 지형 이미지에서 밝습니다. 나머지 이미지의 구조나 형태가 무엇인지는 불분명합니다. 오른쪽의 위상 이미지는 어떤 영역이 실리카인지 명확하게 보여줍니다. 어두운 영역은 위상 이동이 낮은 영역(약 -50°)을 나타냅니다. 밝은 영역은 훨씬 더 높은 위상 이동(약 30°)을 가지며 폴리머 매트릭스를 나타냅니다. 이는 실리카 입자가 고분자 매트릭스와 매우 다른 특성을 가지고 있기 때문입니다.
nGauge AFM 팁은 강력하고 내구성이 있으며 사용하기 쉽습니다.
내장 스캐너와 센서를 사용하면 몇 초 안에 이미징을 시작할 수 있습니다.

nGauge AFM 팁은 초-저 태핑 힘으로 샘플에 접근하며 재료는 수명을 최대화하고 샘플 손상을 최소화하도록 선택되었습니다.
모든 프로브는 표면 에너지가 낮은 재료로 만들어져 우수한 내오염성을 제공합니다.
고종횡비 DLC(diamond-like carbon) 팁은 뛰어난 측면 분해능을 제공하며 단일 nm 구조, 밀집된 피처 및 트렌치 측정과 같은 까다로운 응용 분야에 적합합니다.
DLC는 내마모성이 뛰어난 소재로 표준 알루미늄 팁과 동일한 내구성을 제공합니다. DLC 팁은 눈에 띄는 마모 없이 수백 번 스캔할 수 있습니다. DLC는 또한 낮은 표면 에너지를 가지고 있어 우수한 내오염성을 제공합니다.
당사의 DLC 팁은 대칭의 고화질 스캔을 제공하기 위해 기울기 보정됩니다. DLC 팁은 높이가 >1μm이고 높이가 3μm인 팁 포스트 상단에 15º 각도로 위치합니다.
최적: 고해상도 이미징, 작은 나노구조, 고종횡비 나노 및 마이크로구조, 트렌치.
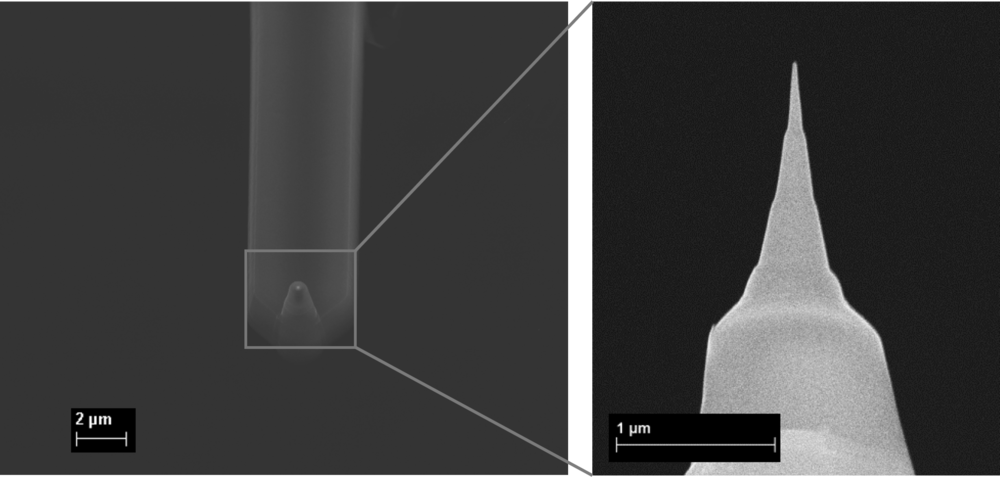
모든 nGauge AFM 칩은 Cantilever 사양이 동일합니다. 강성이 낮기 때문에 눈에 띄는 마모 없이 수백 또는 수천 번의 스캔을 수행할 수 있습니다.
nGauge AFM Tip은 Cantilever 빔의 맨 끝에 있습니다.
nGauge AFM 팁은 MEMS(Micro-Electro-Mechanical Systems) 칩에 통합되어 있습니다. 이 칩은 측면 및 수직 Actuators와 압저항 센서가 통합되어 있습니다. 칩은 자체 감지 및 자체 작동합니다.
* Cantilever란 탐침봉 같은 것으로 끝에 Tip이 있습니다.

ICSPI는 개별 과학자와 자체 실험실이 나노 스케일로 3D 이미지를 캡처할 수 있도록 설계된 사용하기 쉽고 저렴한 벤치탑 원자현미경 기기를 개발하고 생산합니다.
ICSPI의 주력 기기인 AFM-on-a-Chip 기술을 통합한 nGauge AFM은 연구원과 과학자에게 자체 연구실과 벤치에서 나노 규모의 3D 스캔을 약 2분 만에 제공합니다.
ICSPI는 캐나다 온타리오주 키치너-워털루에 본사를 두고 있습니다.